在半导体制造行业,精密工艺控制对于确保产品质量和提升生产效率非常重要。等离子体增强化学气相沉积(PECVD)技术作为一项关键技术,在薄膜沉积工艺中扮演着重要角色。通过利用等离子体中的活性粒子促进化学反应,PECVD能够在相对低温的环境下生成高质量的薄膜。然而,该过程对气体流量的精确调控要求极高。在这种情况下,MFC2000系列气体质量流量控制器凭借其卓越的精度、稳定性及强大的控制能力,成为半导体PECVD工艺不可或缺的一部分。
在PECVD工艺流程中,MFC设备能够精准地测量并调整进入反应室的气体流量,保证反应气体供给的准确性。这对于控制薄膜厚度、均匀性以及提高沉积速率尤为关键。MFC采用先进的流量传感技术和比例阀控制技术,实现了对气体流量的精细调节。它能实时监控流体流量的变化,确保PECVD过程的稳定性和一致性,有助于及时识别并解决潜在的设备问题,保障设备长期稳定运行。
一、PECVD 基本原理
在低气压下,利用低温等离子体*在工艺腔体阴极产生辉光放电,通过辉光放电或加热体使衬底升温至预定温度,通入适量工艺气体,经化学反应和等离子体反应在样品表面形成固态薄膜。
低温等离子体*,指包括电子、各种离子、原子和自由基的混合体,体系中物质非完全电离,电子温度远高于离子温度,但宏观表现上温度相对较低,总体处于非热平衡状态,故又称为非平衡态等离子体。
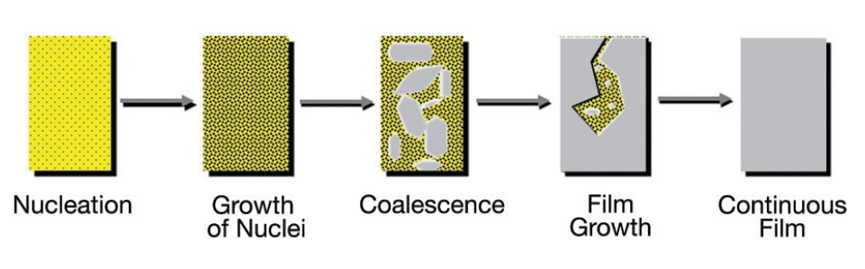 反应过程中,气体从进气口进入工艺腔体扩散至衬底表面,在射频源激发的电场作用下分解成电子、离子和自由基等,发生化学反应生成形成膜的初始成分和副反应物,以化学键形式吸附到衬底表面形成晶核,晶核生长成岛状物再形成连续薄膜,副产物从膜表面脱离并在真空泵作用下排出。
反应过程中,气体从进气口进入工艺腔体扩散至衬底表面,在射频源激发的电场作用下分解成电子、离子和自由基等,发生化学反应生成形成膜的初始成分和副反应物,以化学键形式吸附到衬底表面形成晶核,晶核生长成岛状物再形成连续薄膜,副产物从膜表面脱离并在真空泵作用下排出。
二、PECVD 基本分类
按照等离子体发生的频率来分,PECVD 中所用的等离子体可以分为射频等离子体(Radio Frequency Plasma)和微波等离子体(Microwave Plasma)两种。目前,业界所用的射频频率一般为 13.56MHz。射频等离子耦合方式通常分为电容耦合(CCP)和电感耦合(ICP) 两种。
目前 PECVD 主要应用双频电源,由 400kHz 和 13.56MHz 构成,两个电源最高功率均为 3000W。相比于单一电源,高频和低频相结合的双频驱动可以显著地降低启辉电压,更有利于获得稳定的等离子体源,减弱带电粒子对沉积衬底的轰击及额外损伤,提高了工艺自由度。双频电源系统可选工作模式:①高低频同时作用于反应室,高频为主,低频调制为辅;②高低频交替作用于反应室,可以快速切换;③高低频单独作用于反应室,独立控制工作。
三、PECVD 基本结构
1)真空和压力控制系统:包括机械泵、分子泵、真空阀、真空计等。为减少氮气、氧气及水蒸气影响,采用干泵和分子泵抽气,干泵抽低真空避免油气污染基片,分子泵抽高真空,除水蒸气能力强。
2)淀积系统:由射频电源、水冷系统、衬底加热器等组成,是 PECVD 的核心部分。射频电源使反应气体离子化,水冷系统为泵提供冷却并在超温时报警,冷却水管路采用绝缘材料。加热器使衬底升温除杂质,提高薄膜与衬底的附着力。
3)气体及流量控制系统:气源由气体钢瓶供气,经气柜输送至工艺腔体,采用质量流量控制器精确控制气体流量。
下面来自ISweek工采网代理美国SIARGO的一款高精度,量程范围宽可选的MEMS气体质量流量控制器MFC2000系列。
MFC2000系列质量流量控制器采用公司专有的MEMS Thermal-D操作TM热量传感技术与智能控制电子设备,这种独特的质量流量传感技术消除了一些扩散率相似的气体的气体敏感性,并允许在编程后进行气体识别。本产品可用干动态范围为100:1的过程控制,其控制范围为0.1至0.8MPa(15至120 PSL)的压力和0至50℃的补偿温度。量程在50mL/min到200L/min不同范围可选,带有数字RS485 Modbus通信和模拟输出。
该产品的设计便于更换机械连接器,标准连接器可选双卡套、VCR或UNF,其他定制连接器可根据要求提供。SIARGO的MFC2000质量流量控制器在PECVD设备中具有很重要的作用,可以精准测量和控制气体流量的大小。
转载请注明出处:传感器应用_仪表仪器应用_电子元器件产品 – 工采资讯 http://news.isweek.cn/40094.html